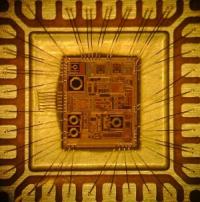
Service
Wire Bonding Services
From 25 µm gold ball for fine-pitch consumer die to 500 µm aluminum ribbon for power modules, our wire bonding line covers the full spectrum of interconnect processes with ball-shear, wire-pull and visual inspection supported in-house.
- Thermosonic gold ball bonding (25 µm)
- Ultrasonic aluminum wedge bonding (1 mil)
- Heavy aluminum wedge to 500 µm
- Stud bumping for flip-chip preparation
- Ball-shear and wire-pull test in-house
- 35 µm minimum pad pitch
Capabilities
Process specifications
A snapshot of the parameters our wire bonding services line supports. Have a requirement that falls outside the table? Contact us — chances are we can accommodate it.
| Parameter | Specification |
|---|---|
| Gold wire | 25 µm and 32 µm ball bonding |
| Aluminum wire | 1-mil and 1.5-mil wedge |
| Heavy wire | 75 µm to 500 µm Al wedge |
| Minimum pitch | 35 µm (inline gold ball) |
| Bond test | Pull strength, ball shear, destructive & non-destructive |
| Packages | QFN, QFP, BGA, ceramic, COB, leadframe |
| Equipment | K&S, ESEC Micron 2, Hesse BJ820 |
Explore more